终检设备
MI系列产品是鉴微半导体自主研发的针对SiC衬底片、外延片的高速率缺陷终检设备。该系列产品具有以下特点:
1. 多模态检测方式:该设备集合大角度暗场散射,小角度暗场散射,可见光光致发光,近紫外光致发光,微分干涉,径向表面,切向表面,明场反射等多种照明探测方式,可以适应不同类型的缺陷检测需求,提高检测的全面性和准确性。
2. 高速率检测:设备采用先进的光学探测方案及高速数据采集处理技术,能够快速准确地检测SiC衬底片、外延片的缺陷,提高生产效率。
3. 基于深度学习的缺陷检测分类算法:设备采用先进的深度学习算法,能够准确地识别各种类型的缺陷,提高检测的精度和稳定性。
MI
化合物半导体宏观缺陷检测设备
| 技术参数 | 可性能指标 |
| 可检测样品 | SiC衬底片,SiC外延片 |
| 检测通道 | 大角度暗场散射,小角度暗场散射 可见光光致发光,近紫外光致发光 微分干涉,径向表面 切向表面,明场反射 |
| 样品尺寸 | 4,6,8寸 |
| 典型检测速率 | ≥12WPH@6inch |
| 检测灵敏度 | 60nm PSL@Si |

检测类型:
| 样品类型 | 可检测缺陷 |
| SiC衬底片 | 颗粒,微管,划伤,包裹,凸起,凹坑,絮状物,晶界,堆叠层错等 |
| SiC外延片 | 颗粒,微管,划伤,凸起,凹坑,三角形,掉落物,胡萝卜,台阶聚集,晶界,堆叠层错,基平面位错等 |
检测效果展示:
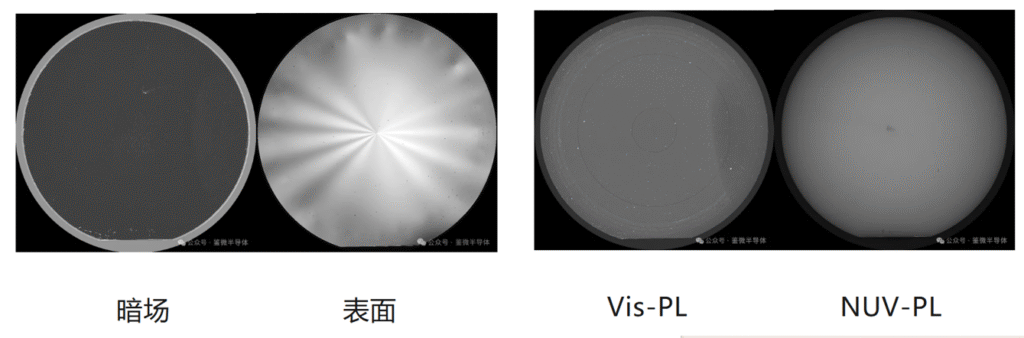
典型缺陷示例:
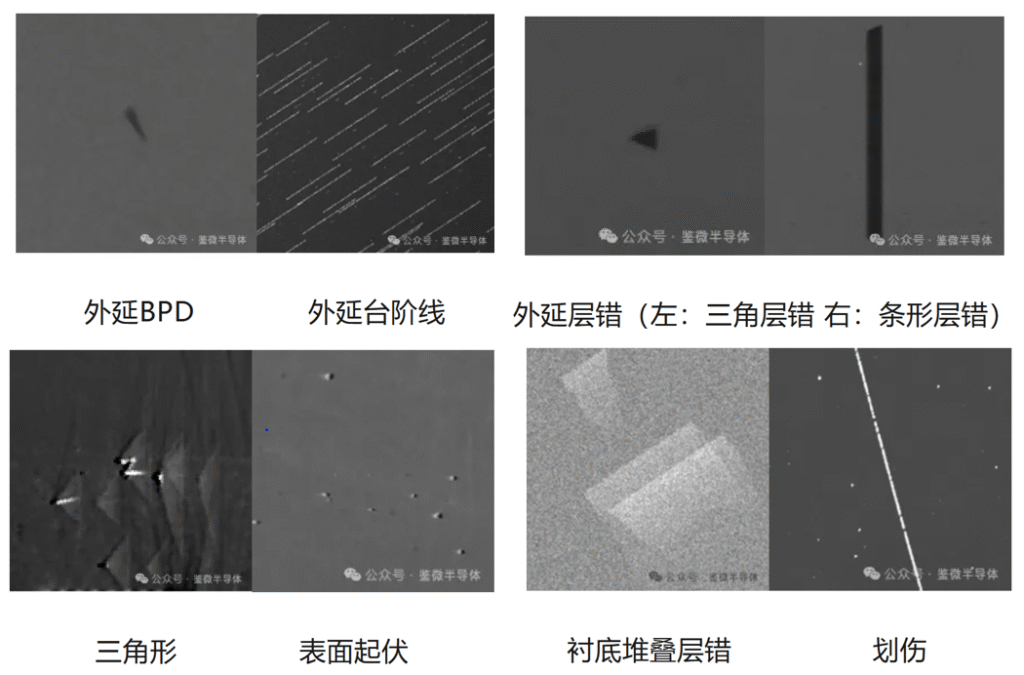
以碳化硅为代表的第三代半导体材料,由于其在高压、高频电阻等方面的优异特性广泛应用于大功率高频电子器件、电动汽车PCU、光伏逆变器、轨道交通电源控制系统等领域。能够起到减小器件体积、提高功率密度的作用,成为推进电力电子产业发展的关键。
未来,随着碳化硅材料逐渐走向平民化,其应用市场也将随之快速发展,对检测设备精度和效率的要求也会越来越高。鉴微半导体将持续深耕三代半领域,推动检测设备的国产化,以满足不断增长的市场需求,为国家半导体及相关产业的发展贡献力量。
